半導(dǎo)體技術(shù)的進步使得芯片的尺寸得以不斷縮小,倒逼著封裝技術(shù)的發(fā)展和進步,,也由此產(chǎn)生了各種各樣的封裝形式,。當(dāng)前功率器件的設(shè)計和發(fā)展具有低電感、高散熱和高絕緣能力的屬性特征,,器件封裝上呈現(xiàn)出模塊化,、多功能化和體積緊湊化的發(fā)展趨勢。為實現(xiàn)封裝器件低電感設(shè)計,,器件封裝結(jié)構(gòu)更加緊湊,,而芯片電壓等級和封裝模塊的功率密度持續(xù)提高,給封裝絕緣和器件散熱帶來挑戰(zhàn),。在有限的封裝空間內(nèi),,如何把芯片的耗散熱及時高效的釋放到外界環(huán)境中以降低芯片結(jié)溫及器件內(nèi)部各封裝材料的工作溫度,已成為當(dāng)前功率器件封裝設(shè)計階段需要考慮的重要問題之一,。IGBT自動化設(shè)備的動態(tài)測試可驗證器件在高頻環(huán)境下的穩(wěn)定性和響應(yīng),。動態(tài)測試超聲波鍵合機批發(fā)價格
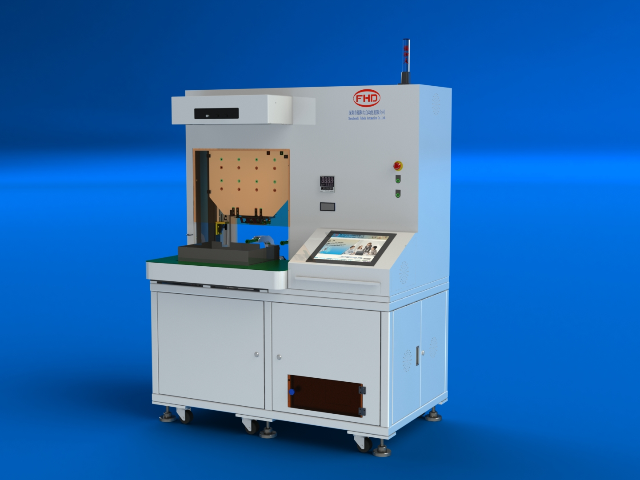
4種AlN基板可靠性測試(冷熱沖擊):對4種AlN覆銅基板循環(huán)進行冷熱沖擊熱循環(huán)實驗,,條件為在-55℃~150℃,每個溫度保溫30min,,5s內(nèi)完成到155℃溫度轉(zhuǎn)換,,循環(huán)次數(shù)為100cycles、500cycles,、1000cycles,、1500cycles??傻肁MB法制備的AlN覆銅板耐熱沖擊次數(shù)明顯高于其他制備工藝,。AlN覆銅板耐熱沖擊主要的失效模式為金屬層剝離和AlN陶瓷基板開裂。對于DPC基板,,在200次冷熱循環(huán)后,,金屬層與AlN完全剝離,剝離強度為0,。AlN厚膜覆銅板,,在500次冷熱循環(huán)后,金屬層有局部剝離,,剝離強度降為百分之二十,。DBC基板在1000次冷熱循環(huán)后,剝離強度降低了20%,,但去除金屬層,,通過超聲波掃描顯微鏡探測,與銅結(jié)合邊緣處AlN基板有微裂紋,,這是由于金屬Cu和AlN的熱膨脹系數(shù)差別大,,兩者在高溫急速降溫過程中,材料內(nèi)部存在大量的熱應(yīng)力,,而導(dǎo)致開裂,。AMB基板在1500次冷熱循環(huán)后,金屬層剝離力無下降現(xiàn)象,,陶瓷表面無微裂紋,。由于金屬層與AlN陶瓷之間有剛度較低的活性釬料過渡層,可以避免大量的熱應(yīng)力形成而造成的AlN陶瓷基板微裂紋產(chǎn)生,。非標(biāo)真空灌膠自動線批發(fā)價格自動化設(shè)備的應(yīng)用使IGBT模塊的封裝工藝更加智能化和高效化,。

IGBT作為重要的電力電子的中心器件,其可靠性是決定整個裝置安全運行的重要因素,。由于IGBT采取了疊層封裝技術(shù),,該技術(shù)不但提高了封裝密度,同時也縮短了芯片之間導(dǎo)線的互連長度,從而提高了器件的運行速率,。傳統(tǒng)Si基功率模塊封裝存在寄生參數(shù)過高,散熱效率差的問題,,這主要是由于傳統(tǒng)封裝采用了引線鍵合和單邊散熱技術(shù),,針對這兩大問題,SiC功率模塊封裝在結(jié)構(gòu)上采用了無引線互連(wireless interconnection)和雙面散熱(double-side cooling)技術(shù),,同時選用了導(dǎo)熱系數(shù)更好的襯底材料,,并嘗試在模塊結(jié)構(gòu)中集成去耦電容、溫度/電流傳感器以及驅(qū)動電路等,,研發(fā)出了多種不同的模塊封裝技術(shù),。
IGBT模塊究竟如何工作?在電控模塊中,,IGBT模塊是逆變器的中心部件,,總結(jié)其工作原理:通過非通即斷的半導(dǎo)體特性,不考慮過渡過程和寄生效應(yīng),,我們將單個IGBT芯片看做一個理想的開關(guān),。我們在模塊內(nèi)部搭建起若干個IGBT芯片單元的并串聯(lián)結(jié)構(gòu),當(dāng)直流電通過模塊時,,通過不同開關(guān)組合的快速開斷,,來改變電流的流出方向和頻率,從而輸出得到我們想要的交流電,。IGBT模塊實物長啥樣,?IGBT模塊的標(biāo)準(zhǔn)封裝形式是一個扁平的類長方體,下圖為HP1模塊的正上方視角,,外面白色的都是塑料外殼,,底部是導(dǎo)熱散熱的金屬底板(一般是銅材料)。動態(tài)測試IGBT自動化設(shè)備可精確測量器件的開關(guān)速度和損耗,。

目前商用的SiC肖特基二極管受限于傳統(tǒng)塑料封裝形式,,其額定工作結(jié)溫上限只能達到175℃。現(xiàn)有SiC器件的封裝仍主要采用焊接封裝,,考慮到芯片絕緣和隔離外界環(huán)境的目的,,封裝模塊內(nèi)部灌封有完全覆蓋芯片表面的熱導(dǎo)率較低的硅凝膠,硅凝膠上層為空氣,,該封裝形式也使得這種從上向下的熱傳導(dǎo)成為芯片產(chǎn)生熱量的散熱通道,。為了充分利用SiC器件高結(jié)溫的優(yōu)勢,發(fā)揮SiC器件的潛力,,開發(fā)新的便于芯片散熱的封裝結(jié)構(gòu),,為芯片封裝提供高效的散熱路徑,達到降低芯片結(jié)溫,提升器件整體性能的目的,,非常有必要改進現(xiàn)有的傳統(tǒng)功率器件封裝技術(shù),,開發(fā)新型功率器件封裝結(jié)構(gòu)。由此,,通過增加封裝器件的散熱路徑來提高器件散熱能力的方法也就很自然的被提出,。超聲波清洗步驟中,IGBT自動化設(shè)備能夠有效去除焊接后的污染物,,保證封裝質(zhì)量,。動態(tài)測試真空灌膠自動線制造商
在殼體灌膠與固化過程中,IGBT自動化設(shè)備能夠確保完整的絕緣保護和固化效果,。動態(tài)測試超聲波鍵合機批發(fā)價格
無鍵合線單面散熱:取消鍵合線有助于改善器件封裝寄生電感和封裝可靠性,。超緊湊高可靠性SiCMOSFET模塊,取消鍵合線和底板,,將芯片直接焊接到基板上,,采用銅針取代鋁鍵合線,同時在高導(dǎo)熱SiN陶瓷上設(shè)計了類似于熱擴散器的更厚銅塊,,具有更好的傳熱效果,。相比Al2O3陶瓷基板的鍵合線結(jié)構(gòu),采用Al2O3陶瓷的厚銅塊封裝模塊結(jié)殼熱阻降低37%,,采用SiN陶瓷的厚銅塊封裝模塊結(jié)殼熱阻降低55%,。同時該封裝采用新型環(huán)氧樹脂和銀燒結(jié)技術(shù),具有高達200℃的高溫運行能力,。動態(tài)測試超聲波鍵合機批發(fā)價格



